近日,中国科大微电子学院两篇论文入选第35届功率半导体器件和集成电路国际会议(IEEE ISPSD,全称:IEEE International Symposium on Power Semiconductor Devices and ICs)。IEEE ISPSD是功率半导体器件和集成电路领域在国际上重要的知名学术会议,ISPSD 2023于5月28日至6月1日在中国香港举办。会上,龙世兵教授受邀作了题为“Gallium Oxide Vertical Power Devices: Technology, Design and Applications”的大会Short course报告,向国际同行介绍了氧化镓(β-Ga2O3)作为超宽禁带半导体材料在肖特基势垒二极管(SBD)、异质PN结二极管(PND)、场效应晶体管(FET)和功率IC等电力电子器件中的重要应用,系统介绍了Ga2O3基功率器件的发展,包括β-Ga2O3单晶衬底和外延膜生长,SBD、PND和MOSFET功率器件的仿真、设计和研制,以及β-Ga2O3功率模块的设计研制,现场反响热烈。

图1. 龙世兵教授做Short course报告
本次入选的两篇oral论文工作如下:
1.高耐压低损耗低漏电氧化镓二极管
在当前的β-Ga2O3肖特基势垒二极管(SBD)功率器件研究方面,各界一直主要致力于缓解击穿电压(Vbr)与比导通电阻(Ron,sp)之间的矛盾关系,其中与NiO/β-Ga2O3异质结工程相关的新型结构开始引起研究人员的关注,这一异质结技术克服了缺乏p型掺杂的挑战,实现了4.7 kV的高耐压器件。然而,由于氧化镓材料的宽带隙,异质结二极管(HJD)中存在超过2 V的大正向压降(ISPSD 2022 105),这导致器件具有较大的传导损耗;SBD虽然正向压降低,但高反向电场导致了大的反向漏电流,尽管通过采用NiO/β-Ga2O3异质结构作为结终端扩展(JTE)对此有所改善(IEDM 2022 9.5),但反向漏电流仍然很大。
在这项工作中,通过采用p型NiO制备了具有混合单极和双极型的垂直β-Ga2O3异质结势垒肖特基二极管(HJBS),阳极边缘采用NiO薄膜用作JTE抑制电极边缘电场集聚效应,该器件结合了SBD的低正向压降和HJD的高阻断电压、低反向漏电的优点。当正向电压超过HJD的导通电压时,电流传导模式从高导通电阻的单极性模式转变为低导通电阻的双极性模式,实验结果初步证明了β-Ga2O3HJBS中存在双极行为。研究成果以“1 kV Verticalβ-Ga2O3Heterojunction Barrier Schottky Diode with Hybrid Unipolar and Bipolar Operation”为题发表在IEEE ISPSD 2023上,第一作者为我校微电子学院博士生郝伟兵,微电子学院徐光伟特任副研究员为论文通讯作者。
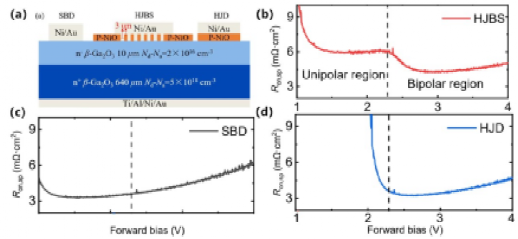
图2. (a) β-Ga2O3 SBD、HJBS、HJD的器件结构对比图;半径为55 μm的(b) HJBS、(c) SBD、(d) HJD器件的Ron,sp
2.垂直型GaN-on-GaN功率二极管浪涌特性研究
相较于传统平面型GaN-on-Si器件,垂直型GaN-on-GaN器件能够拓展其电压和功率等级,并具有优异的动态性能。在功率变换器开关等过程中,功率二极管通常需要承受较大浪涌电流。对于Si和SiC双极型器件,电导调制对提升浪涌能力具有积极作用。而不同于Si或SiC器件,GaN为直接带隙半导体,电子和空穴可通过辐射复合发出光子,本征少子寿命较短。因此,在直接带隙GaN器件中能否发生电导调制、以及其能否在浪涌过程中有效发挥作用仍未有充足的实验验证。同时,垂直型GaN-on-GaN器件的浪涌电流能力随着浪涌脉冲时间(tsurge)和峰值浪涌电流(Ipeak)的演化及其潜在机制尚待研究。
在中国科学技术大学微纳研究与制造中心平台上,课题组自研了具有2 kV耐压能力、较低导通电阻的垂直型GaN-on-GaN PiN二极管。本工作系统研究了一系列tsurge(5 μs~10 ms)和Ipeak(1~10 A)下垂直型GaN-on-GaN PiN二极管浪涌能力的动态演化过程,发现垂直型GaN-on-GaN PiN二极管中光子增强或热增强的电导调制可有效提升其导通能力,使得浪涌电流瞬态中的电流-电压特性(I-V)呈现逆时针回滞。研究成果以“Surge Current Ruggedness in Vertical GaN-on-GaN PiN Diode: Role of Conductivity Modulation”为题发表在IEEE ISPSD 2023上,第一作者为我校微电子学院博士生杜佳宏,微电子学院杨树教授为论文通讯作者。
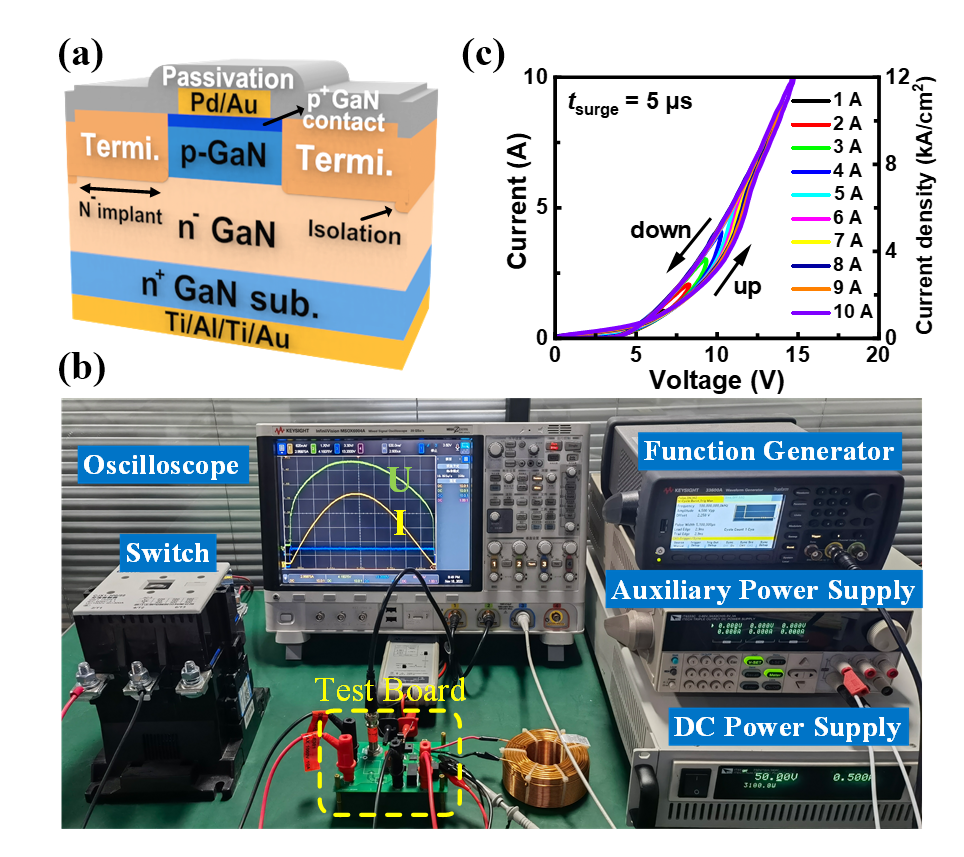
图3. (a)垂直GaN-on-GaN PiN二极管;(b)浪涌测试平台;(c)浪涌测试结果

图4. 参会人员合照:龙世兵教授(右三)、杨树教授(右四)
两项研究得到了国家自然科学基金、中国科学院战略性先导研究计划、中国科学院前沿科学重点研究计划、科技委、广东省重点领域研究发展计划、中国科学技术大学青年创新重点项目、浙江省杰出青年科学基金和台达电力电子重点项目的资助,同时得到了中国科学技术大学微纳研究与制造中心、信息科学实验中心的支持。
ISPSD 2023会议官网:https://ispsd2023.com/
